反應離子刻蝕
| 此條目需要精通或熟悉相關主題的編者參與及協助編輯。 (2012年10月5日) |
| 此條目沒有列出任何參考或來源。 (2012年10月5日) |
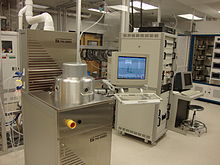
反應離子蝕刻(英文:Reactive-Ion Etching,或簡寫為RIE)是一種半導體生產加工工藝,它利用由等離子體強化後的反應離子氣體轟擊目標材料,來達到刻蝕的目的。氣體在低壓(真空)環境下由電磁場產生,等離子體中的高能離子轟擊晶片表面並與之反應。
設備[編輯]
RIE系統的典型的設備(平行板式)一般包括一個圓柱形真空室,真空室底部放置用來放晶片盤子。盤子與室體的其他部分絕緣。氣體由小口注入真空室上部,由底部排出進入真空泵。氣體的種類和多少取決於蝕刻的程序。比如,六氟化硫經常用來蝕刻矽。通過調節氣體流速以及排氣孔,氣壓一般被保持在幾托(Torr)至幾百托, 其他RIE系統包括感應耦合等離子體RIE(inductively coupled plasma 或者簡稱ICP RIE)。在這種系統中,氣體由射頻(RF)供能的磁場所產生。等離子體的濃度可達非常高,但是蝕刻會變得更加各向同性。 一個平行板式和感應耦合等離子體式所組合而成的RIE也是可以實現的。這一系統中,ICP用來產生高濃度等離子體來加快蝕刻速率,另一單獨加在晶片(矽片)上的射頻(RF)偏壓用來產生定向電場,以達到各向異性的效果。
